キヤノンは、半導体デバイス製造における後工程向けの半導体露光装置の新製品として、0.8µm(マイクロメートル※1)の高解像力と繋ぎ露光による100×100mmの超広画角の露光を可能とすることで、3次元(3D)技術に寄与するi線※2ステッパー“FPA-5520iV LF2オプション”を2023年1月上旬に発売します。

FPA-5520iV LF2オプション
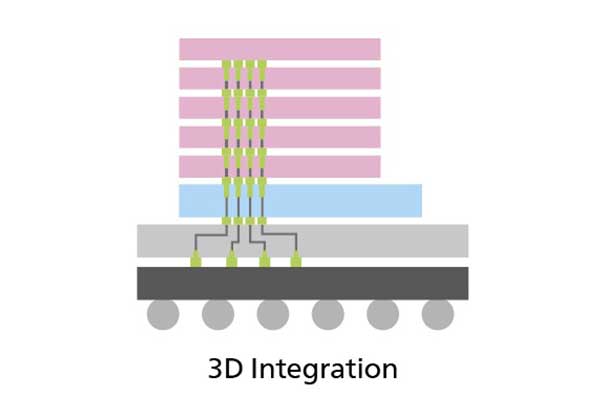
半導体チップ積層により高性能化を目指す3次元技術(イメージ)

4つの露光ショットを繋ぎ合わせて1つの大型パッケージとする例(4ショット×4個)
半導体チップの高性能化においては、半導体製造の前工程での回路の微細化だけでなく、後工程で行われるパッケージングでの高密度化が注目されています。高密度化を実現する先端パッケージングには、微細な配線が必要で、近年では半導体露光装置が使用されるようになっており、複数の半導体チップを並べて密接に接続する2.5次元技術※3や、半導体チップを積層する3次元技術※4により、半導体デバイスの性能を向上したいというニーズがあります。
新製品は、0.8µmの高解像力と露光ひずみの小さい4ショットの繋ぎ露光による100×100mmの超広画角の露光を可能とすることで、2.5次元と3次元技術を組み合わせた超大型・高密度配線パッケージの量産を実現します。
従来機種「FPA-5520iV LFオプション」(2021年4月発売)と比べ、歪曲収差を4分の1以下にまで改善した新投影光学系の搭載と、照度均一性を高めた照明光学系の採用により、52×68mmの広画角でありながら0.8µmの解像力と、繋ぎ露光による100×100mmの超広画角を実現します。
パッケージング工程での量産課題である再構成基板※5の反った形状に対する柔軟な対応力とともに、チップ配列のばらつきが大きい再構成基板でもアライメントマークを検出し稼働率を向上させる高い生産性など、「FPA-5520iV」で実現した基本性能を継承しています。
キヤノンは、半導体チップを製造する前工程だけではなく、後工程での先端パッケージング技術に対応する半導体露光装置のラインアップも拡充することで、さらなる半導体デバイスの技術革新に貢献します。
近年急速に進むIoT化や、コロナ禍で増加したテレワーク、オンライン活動などにより、さまざまな半導体デバイスの需要が高まっています。そのような中で、微細化以外に高性能化を実現する技術の一つとして、パッケージの高密度配線化が提案されています。半導体デバイスのさらなる高性能化に対応できる先端パッケージングの需要が増加することで、今後も後工程における半導体露光装置の市場は拡大すると予測されています。(キヤノン調べ)

上から見たイメージ
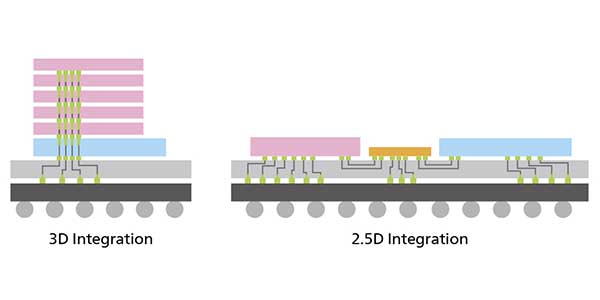
横から見たイメージ

FPA-5520iV LF2オプション
43.2KB(604px×651px)

4つの露光ショットを繋ぎ合わせて1つの大型パッケージとする例(4ショット×4個)
1.17MB(3314px×4019px)
本ページに掲載されている画像、文書その他データの著作権はニュースリリース発行元に帰属します。
また、報道用途以外の商用利用(宣伝、マーケティング、商品化を含む)において、無断で複製、転載することは、著作権者の権利の侵害となります。